
功率氮化镓硅片和SOI衬底硅片,提升高性能的氮化镓生长
随着氮化镓技术推动高性能电源应用的发展,衬底的优化对于氮化镓的成功生长至关重要。Okmetic经过优化的功率氮化镓硅片和SOI硅片可为氮化镓外延提供所需的坚固性。这些硅片具有增强的稳定性、减少晶圆弯曲以及卓越的电气特性,使其成为高性能氮化镓器件的理想平台。
与碳化硅(SiC)和蓝宝石等替代品相比,抛光硅片具有成本效益和良好的可用性,是氮化镓生长的主流解决方案。不过,SOI硅片因其出色的器件隔离、更低的寄生电容和更高的热稳定性而受到越来越多的关注,这些都成为它构建功率器件的关键优势。虽然硅上氮化镓(GaN-on-Si)和碳化硅上氮化镓(GaN-on-SiC)生长技术仍然是高功率应用的既定选择,键合SOI结构正在成为一种颇有前途的替代方案。随着氮化镓生长技术的发展,这些结构在器件集成方面具有独特的优势,可实现更高效、更具扩展性的器件制造。最近校际的微电子中心(IMEC)合作取得了非常好的研究成果,特别是SOI硅片在氮化镓生长方面的潜力。
为氮化镓生长而设计的衬底硅片
Okmetic的功率氮化镓衬底硅片由单面抛光和双面抛光两种,专门为满足氮化镓外延加工的苛刻要求而设计。这些硅片旨在减少硅片的弯曲和翘曲,同时提高其耐用性。我们的功率氮化镓衬底的坚固性得益于我们的先进磁拉法(A-MCz®)长晶工艺,该工艺能够实现超高的掺杂浓度和优化的氧间隙(Oi)水平。该工艺不仅强化了晶格结构,而且还实现了精确的晶向控制,确保了卓越的应力管理。
Okmetic的功率氮化镓衬底设计灵活,可实现完全定制,以满足各种氮化镓应用的特定需求。这些衬底采用<111>晶向,支持高压氮化镓HEMT器件(超过650V)和高功率LED。对于需要增强耐用性的应用,厚度可达>1150µm,可进一步减少弯曲和翘曲。背面处理方式可选择多晶硅和LTO,以提供额外的应力弹性。
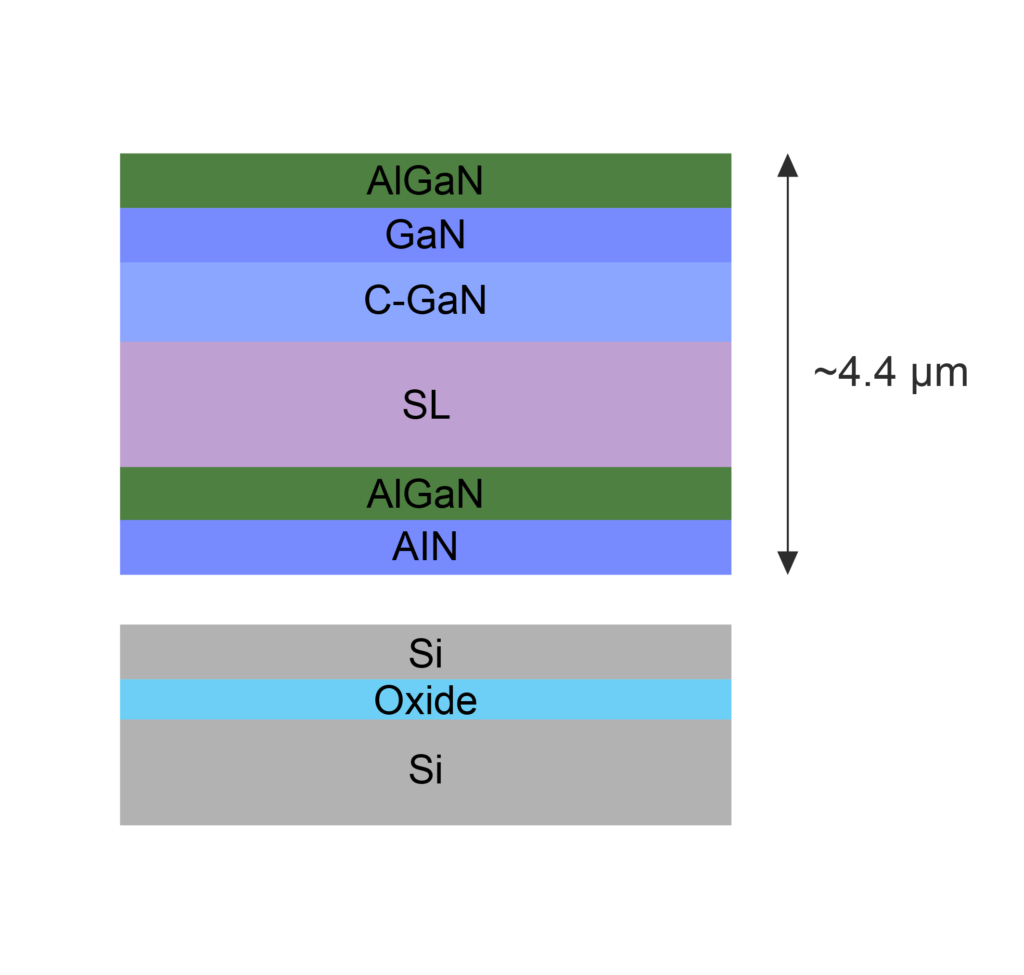
IMEC验证了氮化镓SOI硅片是否可用于高质量的氮化镓外延
IMEC最近的一项研究评估了Okmetic经过优化的氮化镓和未经优化的SOI硅片,比较了它们对氮化镓生长、硅片弯曲和稳定性的影响。IMEC成功地在Okmetic硅片上生长了一个4.4µm的氮化镓外延堆栈,经过优化的氮化镓SOI硅片在生长后研究中表现出卓越的氮化镓层均匀性、硅片弯曲情况减少以及增强的电气性能。IMEC的电气性能测试(包括缓冲击穿、霍尔测量和色散分析)表明,Okmetic的功率氮化镓SOI衬底硅片的性能可与业界领先的材料相媲美,这项结果在研究中作为可用的参考。
这项研究证实了功率氮化镓SOI衬底硅片的稳定性,且适用于高功率应用。它们在高温条件下具有高电气可靠性,并展现了出色的性能,其长期耐用性和高效对于要求严苛的应用来说至关重要。
SOI衬底硅片的规格
经过优化的氮化镓和非经优化的SOI硅片拥有相同的器件层和埋氧层,且底层硅片的厚度也相同。两者都采用了<111>晶向,能够很好地提高硅片的耐用性。这两种硅片之间的主要区别在于经过优化的氮化镓SOI硅片的底层硅片,其中的掺杂和氧间隙(Oi)浓度更高。这种优化大大提高了高温氮化镓生长过程中硅片的坚固性和稳定性,为氮化镓外延提供了理想的平台,避免了损害其结构的完整性。
此外,Okmetic的氮化镓SOI衬底硅片为单片氮化镓集成提供了出色的绝缘性能,可降低寄生电容和漏电流,这是高频器件和功率应用的关键因素。
增强硅片稳定性、电气性能和器件可靠性
针对功率氮化镓优化的SOI硅片具有出色的稳定性,展现出最小的弯曲度、无边缘缺陷,氮化镓层质量统一,确保了高温工艺中的可靠性。在氮化镓生长中机械应力和热应力颇具挑战性,这也凸显出硅片的稳定性对于氮化镓生长的至关重要。
电气测试证实了硅片适用于高性能的氮化镓器件,具有高缓冲击穿电压(反向750V、正向850V)和最小的捕获电荷效应,色散测量证实了这一点。此外,厚度变化最小的氮化铝镓盖层均匀,可确保氮化镓HEMT中稳定的2DEG特性和可靠的阈值电压,支持先进功率应用中的长期可靠性和性能。
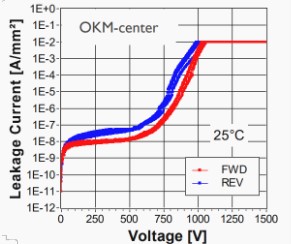
IMEC对0.01平方毫米的样品进行缓冲击穿电压测试,Okmetic的功率氮化镓SOI衬底硅片在约750V反向偏置和850V正向偏置下表现出10⁻⁶ A/mm²的漏电流。

IMEC对Okmetic的功率氮化镓SOI衬底硅片进行缓冲弥散测量,结果显示捕获电荷效应最小,曲线仅轻微加宽,展现出器件性能的优异。

图为氮化铝镓盖层的厚度变化和硅片半径的关系。氮化铝镓盖层表现出出色的均匀性,铝含量始终保持在21%,且硅片的厚度变化最小。